SMT ໃຊ້ການວິເຄາະ ແລະການແກ້ໄຂການເຊື່ອມຕໍ່ການເຊື່ອມຕໍ່ການເຊື່ອມຕໍ່ແຜ່ນແບບທຳມະດາ (2023 Essence Edition), ທ່ານສົມຄວນໄດ້ຮັບມັນ!
1 ບົດແນະນຳ

ໃນການປະກອບແຜ່ນວົງຈອນ, ແຜ່ນ solder ໄດ້ຖືກພິມອອກໃສ່ແຜ່ນ solder ກະດານວົງຈອນທໍາອິດ, ແລະຫຼັງຈາກນັ້ນອົງປະກອບເອເລັກໂຕຣນິກຕ່າງໆໄດ້ຖືກຕິດ. ສຸດທ້າຍ, ຫຼັງຈາກ furnace reflow ໄດ້, beads ກົ່ວໃນ solder paste ແມ່ນ melted ແລະທຸກປະເພດຂອງອົງປະກອບເອເລັກໂຕຣນິກແລະ pad solder ຂອງຄະນະວົງຈອນແມ່ນ welded ຮ່ວມກັນເພື່ອຮັບຮູ້ການປະກອບຂອງ submodules ໄຟຟ້າ. surfacemounttechnology (sMT) ຖືກນໍາໃຊ້ເພີ່ມຂຶ້ນໃນຜະລິດຕະພັນການຫຸ້ມຫໍ່ທີ່ມີຄວາມຫນາແຫນ້ນສູງ, ເຊັ່ນ: ຊຸດລະດັບລະບົບ (siP), ອຸປະກອນ ballgridarray (BGA), ແລະ chip ພະລັງງານເປົ່າ, ຊຸດຮຽບຮ້ອຍ flat pin-less ຊຸດ (quad aatNo-lead, ເອີ້ນວ່າ QFN) ອຸປະກອນ.
ເນື່ອງຈາກຄຸນລັກສະນະຂອງຂະບວນການເຊື່ອມໂລຫະ solder paste ແລະວັດສະດຸ, ຫຼັງຈາກການເຊື່ອມໂລຫະ reflow ຂອງອຸປະກອນພື້ນຜິວ solder ຂະຫນາດໃຫຍ່ເຫຼົ່ານີ້, ຈະມີຮູຢູ່ໃນພື້ນທີ່ການເຊື່ອມໂລຫະ solder, ເຊິ່ງຈະສົ່ງຜົນກະທົບຕໍ່ຄຸນສົມບັດໄຟຟ້າ, ຄຸນສົມບັດຄວາມຮ້ອນແລະຄຸນສົມບັດກົນຈັກຂອງຜະລິດຕະພັນປະສິດທິພາບ, ແລະແມ້ກະທັ້ງນໍາໄປສູ່ຄວາມລົ້ມເຫຼວຂອງຜະລິດຕະພັນ, ດັ່ງນັ້ນ, ການປັບປຸງການເຊື່ອມໂລຫະ solder paste reflow ຢູ່ຕາມໂກນໄດ້ກາຍມາເປັນຂະບວນການແລະບັນຫາດ້ານວິຊາການທີ່ solder ໄດ້ວິເຄາະບາງແລະບັນຫາດ້ານວິຊາການທີ່ຂາຍ Bwelding. ຢູ່ຕາມໂກນ, ແລະການສະຫນອງການແກ້ໄຂການປັບປຸງ, ຂະບວນການເຊື່ອມໂລຫະ solder paste reflow ທໍາມະດາພື້ນທີ່ການເຊື່ອມຂອງ QFN ຫຼາຍກ່ວາ 10mm2 ຫຼືພື້ນທີ່ການເຊື່ອມໂລຫະຫຼາຍກ່ວາ 6 mm2 ຂອງການແກ້ໄຂ chip ເປົ່າແມ່ນຂາດ.
ໃຊ້ການເຊື່ອມໂລຫະ Preformsolder ແລະການເຊື່ອມໂລຫະ furnace reflux ສູນຍາກາດເພື່ອປັບປຸງຮູເຊື່ອມ. solder prefabricated ຕ້ອງການອຸປະກອນພິເສດເພື່ອຊີ້ flux. ສໍາລັບຕົວຢ່າງ, ຊິບຖືກຊົດເຊີຍແລະ tilted ຢ່າງຮຸນແຮງຫຼັງຈາກ chip ໄດ້ຖືກວາງໂດຍກົງໃສ່ solder prefabricated. ຖ້າຫາກວ່າຊິບ flux mount ແມ່ນ reflow ແລະຫຼັງຈາກນັ້ນຈຸດ, ຂະບວນການແມ່ນເພີ່ມຂຶ້ນສອງ reflow, ແລະຄ່າໃຊ້ຈ່າຍຂອງ solder prefabricated ແລະວັດສະດຸ flux ແມ່ນສູງກວ່າ solder paste ຫຼາຍ.
ອຸປະກອນສູນຍາກາດ reflux ມີລາຄາແພງກວ່າ, ຄວາມອາດສາມາດສູນຍາກາດຂອງຫ້ອງສູນຍາກາດເອກະລາດແມ່ນຕໍ່າຫຼາຍ, ການປະຕິບັດຄ່າໃຊ້ຈ່າຍບໍ່ສູງ, ແລະບັນຫາການກະແຈກກະຈາຍຂອງກົ່ວແມ່ນຮ້າຍແຮງ, ເຊິ່ງເປັນປັດໃຈສໍາຄັນໃນການນໍາໃຊ້ຜະລິດຕະພັນທີ່ມີຄວາມຫນາແຫນ້ນສູງແລະຂະຫນາດນ້ອຍ. ໃນເອກະສານສະບັບນີ້, ໂດຍອີງໃສ່ຂະບວນການເຊື່ອມໂລຫະ reflow ຂອງ solder ທໍາມະດາ, ຂະບວນການເຊື່ອມໂລຫະ reflow ຂັ້ນສອງແມ່ນໄດ້ຖືກພັດທະນາແລະແນະນໍາເພື່ອປັບປຸງຮູເຊື່ອມແລະແກ້ໄຂບັນຫາຂອງການເຊື່ອມໂລຫະແລະຮອຍແຕກປະທັບຕາພາດສະຕິກທີ່ເກີດຈາກການເຊື່ອມໂລຫະຢູ່ຕາມໂກນ.
2 solder paste ພິມ reflow ຢູ່ຕາມໂກນການເຊື່ອມໂລຫະແລະກົນໄກການຜະລິດ
2.1 ທໍ່ເຊື່ອມ
ຫຼັງຈາກການເຊື່ອມໂລຫະ reflow, ຜະລິດຕະພັນໄດ້ຖືກທົດສອບພາຍໃຕ້ການ x-ray. ຮູຢູ່ໃນເຂດການເຊື່ອມໂລຫະທີ່ມີສີອ່ອນກວ່າແມ່ນພົບວ່າເປັນຍ້ອນການເຊື່ອມໂລຫະບໍ່ພຽງພໍໃນຊັ້ນເຊື່ອມ, ດັ່ງທີ່ສະແດງໃນຮູບທີ 1.
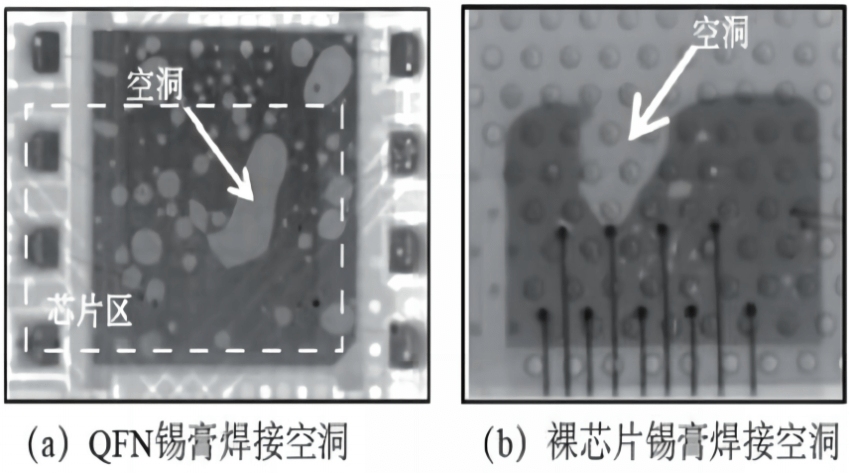
ການກວດ X-ray ຂອງຮູຟອງ
2.2 ກົນໄກການສ້າງຕັ້ງຂອງຢູ່ຕາມໂກນເຊື່ອມ
ເອົາການວາງ solder sAC305 ເປັນຕົວຢ່າງ, ອົງປະກອບແລະຫນ້າທີ່ຕົ້ນຕໍແມ່ນສະແດງຢູ່ໃນຕາຕະລາງ 1. ແຜ່ນ flux ແລະ tin beads ຖືກຜູກມັດເຂົ້າກັນໃນຮູບແບບການວາງ. ອັດຕາສ່ວນນ້ໍາຫນັກຂອງ solder ກົ່ວກັບ flux ແມ່ນກ່ຽວກັບການ 9: 1, ແລະອັດຕາສ່ວນປະລິມານແມ່ນປະມານ 1: 1.

ຫຼັງຈາກແຜ່ນ solder ໄດ້ຖືກພິມອອກແລະ mounted ກັບອົງປະກອບເອເລັກໂຕຣນິກຕ່າງໆ, ການວາງ solder ຈະ undergo ສີ່ຂັ້ນຕອນຂອງການ preheating, ການກະຕຸ້ນ, reflux ແລະຄວາມເຢັນໃນເວລາທີ່ມັນຜ່ານ furnace reflux ໄດ້. ສະຖານະຂອງການວາງ solder ແມ່ນຍັງແຕກຕ່າງກັນກັບອຸນຫະພູມທີ່ແຕກຕ່າງກັນໃນໄລຍະທີ່ແຕກຕ່າງກັນ, ດັ່ງທີ່ສະແດງຢູ່ໃນຮູບ 2.
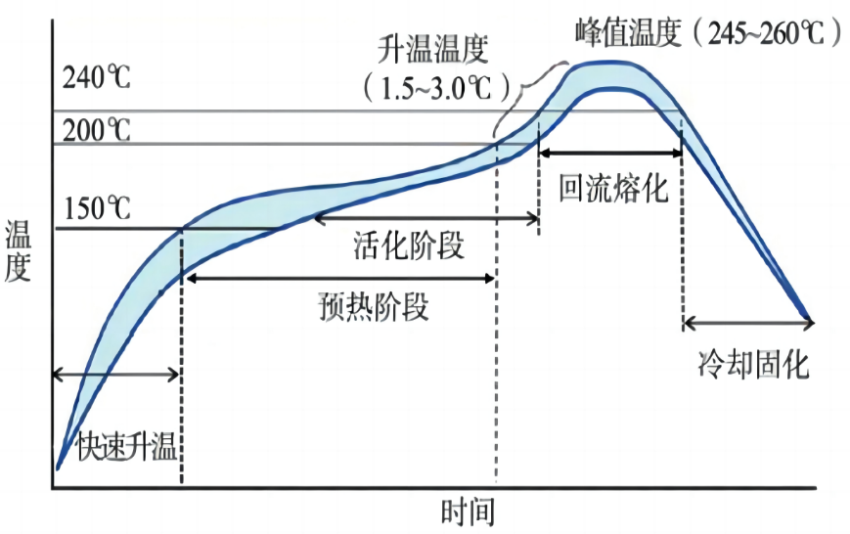
ຂໍ້ມູນອ້າງອີງສໍາລັບແຕ່ລະພື້ນທີ່ຂອງ reflow soldering
ໃນຂັ້ນຕອນ preheating ແລະການກະຕຸ້ນ, ອົງປະກອບທີ່ລະເຫີຍໃນ flux ໃນ solder paste ຈະໄດ້ຮັບການລະເຫີຍເປັນອາຍແກັສໃນເວລາທີ່ຄວາມຮ້ອນ. ໃນເວລາດຽວກັນ, ທາດອາຍຜິດຈະຖືກຜະລິດເມື່ອ oxide ທີ່ຢູ່ດ້ານຂອງຊັ້ນເຊື່ອມໄດ້ຖືກໂຍກຍ້າຍ. ບາງສ່ວນຂອງທາດອາຍຜິດເຫຼົ່ານີ້ຈະລະເຫີຍແລະອອກຈາກການວາງ solder, ແລະລູກປັດ solder ຈະໄດ້ຮັບການ condensed ແຫນ້ນເນື່ອງຈາກ flux volatilization. ໃນຂັ້ນຕອນຂອງການ reflux, flux ທີ່ຍັງເຫຼືອຢູ່ໃນ solder paste ຈະ evaporate ຢ່າງວ່ອງໄວ, beads ກົ່ວຈະລະລາຍ, ຈໍານວນຂະຫນາດນ້ອຍຂອງ flux ອາຍແກັສລະເຫີຍແລະອາກາດສ່ວນໃຫຍ່ລະຫວ່າງ beads ກົ່ວຈະບໍ່ຖືກກະແຈກກະຈາຍຕາມເວລາ, ແລະສ່ວນທີ່ເຫຼືອໃນກົ່ວ molten ແລະພາຍໃຕ້ຄວາມກົດດັນຂອງກົ່ວ molten ແມ່ນ hamburger sandwich ໂຄງສ້າງວົງຈອນແລະແຜ່ນໄຟຟ້າຖືກຈັບໄດ້. ໃນກົ່ວຂອງແຫຼວແມ່ນມີຄວາມຫຍຸ້ງຍາກທີ່ຈະຫນີພຽງແຕ່ໂດຍ buoyancy ຂຶ້ນໄປທີ່ໃຊ້ເວລາ melting ເທິງແມ່ນສັ້ນຫຼາຍ. ເມື່ອກົ່ວ molten ເຢັນລົງແລະກາຍເປັນກົ່ວແຂງ, ຮູຂຸມຂົນຈະປາກົດຢູ່ໃນຊັ້ນການເຊື່ອມໂລຫະແລະຮູ solder ໄດ້ຖືກສ້າງຕັ້ງຂຶ້ນ, ດັ່ງທີ່ສະແດງຢູ່ໃນຮູບ 3.
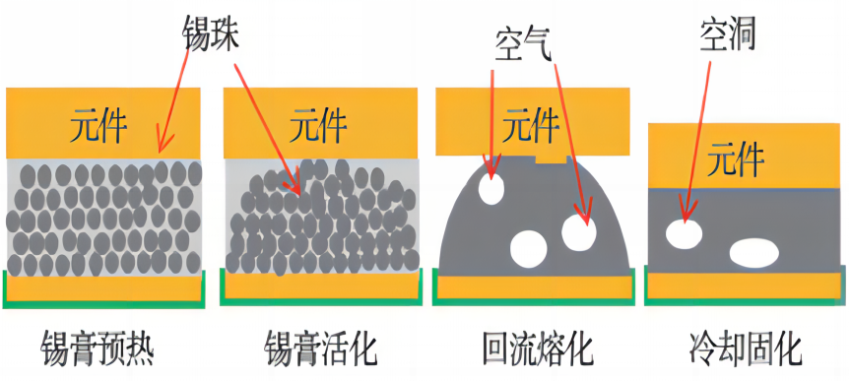
ແຜນວາດ Schematic ຂອງ void ສ້າງຂຶ້ນໂດຍການເຊື່ອມ reflow ວາງ solder
ສາເຫດຂອງການເຊື່ອມໂລຫະຢູ່ຕາມໂກນແມ່ນຍ້ອນອາກາດຫຼືອາຍແກັສທີ່ລະເຫີຍທີ່ຫໍ່ຢູ່ໃນແຜ່ນ solder ຫຼັງຈາກ melting ບໍ່ໄດ້ຖືກປ່ອຍອອກມາຫມົດ. ປັດໄຈທີ່ມີອິດທິພົນປະກອບມີວັດສະດຸວາງ solder, ຮູບຮ່າງການພິມ solder paste, ຈໍານວນການພິມ solder paste, ອຸນຫະພູມ reflux, ເວລາ reflux, ຂະຫນາດການເຊື່ອມໂລຫະ, ໂຄງສ້າງແລະອື່ນໆ.
3. ການກວດສອບປັດໄຈອິດທິພົນຂອງ solder paste ພິມ reflow ຮູເຊື່ອມ
QFN ແລະການທົດສອບ chip ເປົ່າໄດ້ຖືກນໍາໃຊ້ເພື່ອຢືນຢັນສາເຫດຕົ້ນຕໍຂອງ voids ການເຊື່ອມ reflow, ແລະເພື່ອຊອກຫາວິທີທີ່ຈະປັບປຸງ voids ການເຊື່ອມ reflow ພິມໂດຍ solder paste. QFN ແລະ bare chip solder paste reflow welding profile ຜະລິດຕະພັນແມ່ນສະແດງໃຫ້ເຫັນໃນຮູບທີ່ 4, QFN welding ຂະຫນາດຫນ້າດິນແມ່ນ 4.4mmx4.1mm, ດ້ານການເຊື່ອມໂລຫະແມ່ນຊັ້ນ tinned (100% ກົ່ວບໍລິສຸດ); ຂະຫນາດການເຊື່ອມໂລຫະຂອງຊິບເປົ່າແມ່ນ 3.0mmx2.3mm, ຊັ້ນການເຊື່ອມໂລຫະແມ່ນ sputtered nickel-vanadium bimetallic layer, ແລະຊັ້ນຫນ້າດິນແມ່ນ vanadium. ແຜ່ນເຊື່ອມຂອງຊັ້ນລຸ່ມແມ່ນ electroless nickel-palladium gold-dipping, ແລະຄວາມຫນາແມ່ນ 0.4μm / 0.06μm / 0.04μm. SAC305 solder paste ຖືກນໍາໃຊ້, ອຸປະກອນການພິມ solder paste ແມ່ນ DEK Horizon APix, ອຸປະກອນ furnace reflux ແມ່ນ BTUPyramax150N, ແລະອຸປະກອນ x-ray ແມ່ນ DAGExD7500VR.
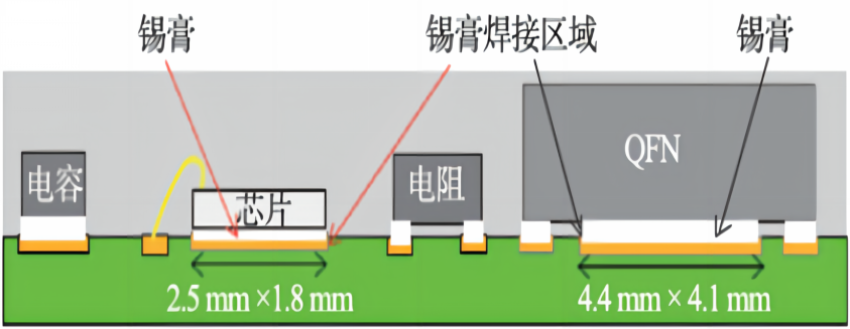
QFN ແລະຮູບແຕ້ມການເຊື່ອມ chip ເປົ່າ
ເພື່ອອໍານວຍຄວາມສະດວກໃນການປຽບທຽບຜົນການທົດສອບ, ການເຊື່ອມໂລຫະ reflow ໄດ້ຖືກປະຕິບັດພາຍໃຕ້ເງື່ອນໄຂໃນຕາຕະລາງ 2.

ຕາຕະລາງເງື່ອນໄຂການເຊື່ອມໂລຫະ Reflow
ຫຼັງຈາກການຕິດຕັ້ງພື້ນຜິວແລະການເຊື່ອມໂລຫະ reflow ສໍາເລັດແລ້ວ, ຊັ້ນການເຊື່ອມໂລຫະໄດ້ຖືກກວດພົບໂດຍ X-ray, ແລະພົບວ່າມີຮູຂະຫນາດໃຫຍ່ຢູ່ໃນຊັ້ນເຊື່ອມຢູ່ດ້ານລຸ່ມຂອງ QFN ແລະຊິບເປົ່າ, ດັ່ງທີ່ສະແດງຢູ່ໃນຮູບ 5.
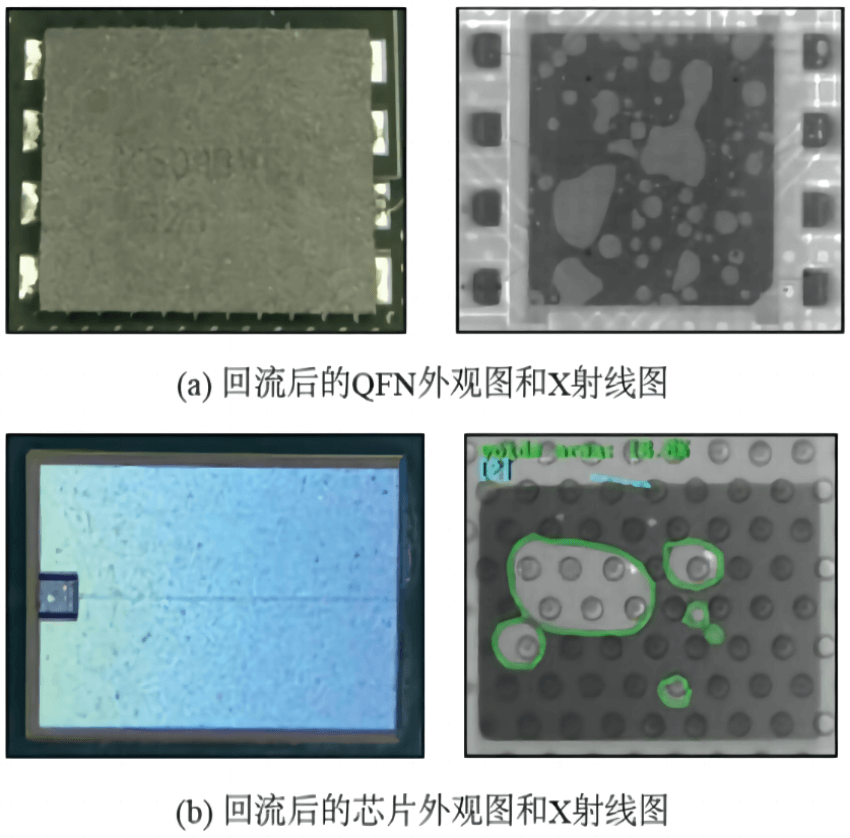
QFN ແລະ Chip Hologram (X-ray)
ນັບຕັ້ງແຕ່ຂະຫນາດຂອງລູກປັດ tin, ຄວາມຫນາຂອງຕາຫນ່າງເຫຼັກ, ອັດຕາການເປີດ, ຮູບຮ່າງຕາຫນ່າງເຫຼັກ, ເວລາ reflux ແລະອຸນຫະພູມ furnace ສູງສຸດທັງຫມົດຈະມີຜົນກະທົບ reflow voids ການເຊື່ອມໂລຫະ, ມີຫຼາຍປັດໃຈອິດທິພົນ, ເຊິ່ງຈະໄດ້ຮັບການກວດສອບໂດຍກົງໂດຍການທົດສອບ DOE, ແລະຈໍານວນຂອງກຸ່ມທົດລອງຈະມີຂະຫນາດໃຫຍ່ເກີນໄປ. ມັນເປັນສິ່ງຈໍາເປັນທີ່ຈະກວດສອບແລະກໍານົດປັດໃຈທີ່ມີອິດທິພົນຕົ້ນຕໍຢ່າງໄວວາໂດຍຜ່ານການທົດສອບການປຽບທຽບຄວາມສໍາພັນ, ແລະຫຼັງຈາກນັ້ນປັບປຸງປັດໃຈອິດທິພົນຕົ້ນຕໍໂດຍຜ່ານ DOE.
3.1 ຂະຫນາດຂອງຮູ solder ແລະ solder paste beads ກົ່ວ
ດ້ວຍ type3 (ຂະຫນາດລູກປັດ 25-45 μm) SAC305 solder paste test, ເງື່ອນໄຂອື່ນໆຍັງຄົງບໍ່ປ່ຽນແປງ. ຫຼັງຈາກ reflow, ຂຸມໃນຊັ້ນ solder ໄດ້ຖືກວັດແທກແລະປຽບທຽບກັບແຜ່ນ solder type4. ມັນພົບເຫັນວ່າຮູໃນຊັ້ນ solder ແມ່ນບໍ່ແຕກຕ່າງກັນຢ່າງຫຼວງຫຼາຍລະຫວ່າງສອງປະເພດຂອງການວາງ solder, ສະແດງໃຫ້ເຫັນວ່າການວາງ solder ທີ່ມີຂະຫນາດ bead ທີ່ແຕກຕ່າງກັນບໍ່ມີອິດທິພົນຢ່າງຈະແຈ້ງກ່ຽວກັບຮູໃນຊັ້ນ solder, ບໍ່ແມ່ນປັດໄຈທີ່ມີອິດທິພົນ, ດັ່ງທີ່ສະແດງຢູ່ໃນຮູບ. 6 ດັ່ງທີ່ສະແດງ.

ການປຽບທຽບຂຸມຜົງກົ່ວໂລຫະທີ່ມີຂະຫນາດຂອງອະນຸພາກທີ່ແຕກຕ່າງກັນ
3.2 ຄວາມຫນາຂອງທໍ່ເຊື່ອມແລະຕາຫນ່າງເຫຼັກພິມ
ຫຼັງຈາກ reflow, ພື້ນທີ່ຢູ່ຕາມໂກນຂອງຊັ້ນການເຊື່ອມໂລຫະໄດ້ຖືກວັດແທກດ້ວຍຕາຫນ່າງເຫຼັກພິມທີ່ມີຄວາມຫນາ 50 μm, 100 μmແລະ 125 μm, ແລະເງື່ອນໄຂອື່ນໆຍັງບໍ່ປ່ຽນແປງ. ມັນພົບວ່າຜົນກະທົບຂອງຄວາມຫນາທີ່ແຕກຕ່າງກັນຂອງຕາຫນ່າງເຫຼັກກ້າ (ວາງ solder) ໃນ QFN ໄດ້ຖືກປຽບທຽບກັບຕາຫນ່າງເຫຼັກພິມທີ່ມີຄວາມຫນາ 75 μmຍ້ອນວ່າຄວາມຫນາຂອງຕາຫນ່າງເຫຼັກເພີ່ມຂຶ້ນ, ພື້ນທີ່ຢູ່ຕາມໂກນຄ່ອຍໆຫຼຸດລົງຊ້າໆ. ຫຼັງຈາກເຖິງຄວາມຫນາທີ່ແນ່ນອນ (100μm), ພື້ນທີ່ຢູ່ຕາມໂກນຈະປີ້ນກັບກັນແລະເລີ່ມຕົ້ນເພີ່ມຂຶ້ນດ້ວຍການເພີ່ມຄວາມຫນາຂອງຕາຫນ່າງເຫຼັກ, ດັ່ງທີ່ສະແດງໃນຮູບ 7.
ນີ້ສະແດງໃຫ້ເຫັນວ່າໃນເວລາທີ່ປະລິມານຂອງ solder paste ແມ່ນເພີ່ມຂຶ້ນ, ກົ່ວຂອງແຫຼວທີ່ມີ reflux ໄດ້ກວມເອົາໂດຍ chip, ແລະ outlet ຂອງ escape ອາກາດທີ່ຕົກຄ້າງແມ່ນແຄບພຽງແຕ່ສີ່ດ້ານ. ເມື່ອຈໍານວນການວາງ solder ມີການປ່ຽນແປງ, ຊ່ອງອອກຂອງອາກາດທີ່ຕົກຄ້າງຍັງເພີ່ມຂຶ້ນ, ແລະການລະເບີດຂອງອາກາດທັນທີທີ່ຫໍ່ດ້ວຍກົ່ວແຫຼວຫຼືອາຍແກັສທີ່ລະເຫີຍທີ່ຫນີກົ່ວຂອງແຫຼວຈະເຮັດໃຫ້ກົ່ວຂອງແຫຼວ splash ປະມານ QFN ແລະຊິບ.
ການທົດສອບພົບວ່າດ້ວຍການເພີ່ມຄວາມຫນາຂອງຕາຫນ່າງເຫຼັກກ້າ, ການລະເບີດຂອງຟອງທີ່ເກີດຈາກການຫລົບຫນີຂອງອາກາດຫຼືອາຍແກັສທີ່ລະເຫີຍກໍ່ຈະເພີ່ມຂຶ້ນ, ແລະຄວາມເປັນໄປໄດ້ຂອງກົ່ວ splashing ອ້ອມຮອບ QFN ແລະ chip ຈະເພີ່ມຂຶ້ນຕາມທີ່ສອດຄ້ອງກັນ.

ການປຽບທຽບຂຸມໃນຕາຫນ່າງເຫຼັກທີ່ມີຄວາມຫນາແຕກຕ່າງກັນ
3.3 ອັດຕາສ່ວນພື້ນທີ່ຂອງຢູ່ຕາມໂກນເຊື່ອມແລະການເປີດຕາຫນ່າງເຫຼັກ
ຕາຫນ່າງເຫຼັກພິມທີ່ມີອັດຕາການເປີດຂອງ 100%, 90% ແລະ 80% ໄດ້ຖືກທົດສອບ, ແລະເງື່ອນໄຂອື່ນໆຍັງຄົງບໍ່ປ່ຽນແປງ. ຫຼັງຈາກ reflow, ພື້ນທີ່ຢູ່ຕາມໂກນຂອງຊັ້ນການເຊື່ອມໂລຫະໄດ້ຖືກວັດແທກແລະປຽບທຽບກັບຕາຫນ່າງເຫຼັກພິມທີ່ມີອັດຕາການເປີດ 100%. ມັນໄດ້ຖືກພົບເຫັນວ່າບໍ່ມີຄວາມແຕກຕ່າງກັນຢ່າງຫຼວງຫຼາຍໃນຮູຂອງຊັ້ນການເຊື່ອມໂລຫະພາຍໃຕ້ເງື່ອນໄຂຂອງອັດຕາການເປີດຂອງ 100% ແລະ 90% 80%, ດັ່ງທີ່ສະແດງຢູ່ໃນຮູບ 8.

Cavity ການປຽບທຽບພື້ນທີ່ເປີດທີ່ແຕກຕ່າງກັນຂອງຕາຫນ່າງເຫຼັກທີ່ແຕກຕ່າງກັນ
3.4 ເຊື່ອມຢູ່ຕາມໂກນແລະຮູບຮ່າງຕາຫນ່າງເຫຼັກພິມ
ດ້ວຍການທົດສອບຮູບຮ່າງຂອງການພິມຂອງແຜ່ນ solder ຂອງເສັ້ນດ່າງ b ແລະ inclined grid, ເງື່ອນໄຂອື່ນໆຍັງຄົງບໍ່ປ່ຽນແປງ. ຫຼັງຈາກ reflow, ພື້ນທີ່ຢູ່ຕາມໂກນຂອງຊັ້ນການເຊື່ອມໂລຫະໄດ້ຖືກວັດແທກແລະປຽບທຽບກັບຮູບແບບການພິມຂອງຕາຂ່າຍໄຟຟ້າ a. ມັນພົບເຫັນວ່າບໍ່ມີຄວາມແຕກຕ່າງກັນຢ່າງຫຼວງຫຼາຍໃນຮູຂອງຊັ້ນການເຊື່ອມໂລຫະພາຍໃຕ້ເງື່ອນໄຂຂອງຕາຂ່າຍໄຟຟ້າ, ເສັ້ນດ່າງແລະຕາຂ່າຍໄຟຟ້າ inclined, ດັ່ງທີ່ສະແດງໃນຮູບ 9.
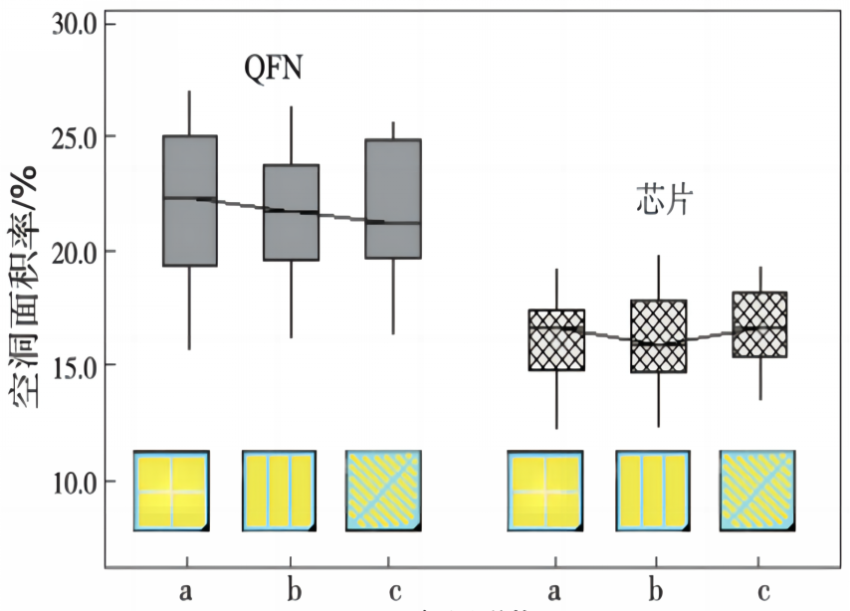
ການປຽບທຽບຂຸມໃນໂຫມດເປີດທີ່ແຕກຕ່າງກັນຂອງຕາຫນ່າງເຫຼັກ
3.5 ທໍ່ເຊື່ອມ ແລະເວລາ reflux
ຫຼັງຈາກເວລາ reflux ຍາວ (70 s, 80 s, 90 s) ການທົດສອບ, ເງື່ອນໄຂອື່ນໆຍັງຄົງບໍ່ປ່ຽນແປງ, ຂຸມໃນຊັ້ນເຊື່ອມໄດ້ຖືກວັດແທກຫຼັງຈາກ reflux, ແລະເມື່ອປຽບທຽບກັບເວລາ reflux ຂອງ 60 s, ພົບວ່າມີການເພີ່ມຂື້ນຂອງເວລາ reflux, ພື້ນທີ່ຂຸມເຊື່ອມຫຼຸດລົງ, ແຕ່ການຫຼຸດຜ່ອນການເພີ່ມຂື້ນຂອງເວລາ amplit ຄ່ອຍໆຫຼຸດລົງ. 10. ນີ້ສະແດງໃຫ້ເຫັນວ່າໃນກໍລະນີທີ່ໃຊ້ເວລາ reflux ບໍ່ພຽງພໍ, ການເພີ່ມເວລາ reflux ແມ່ນເອື້ອອໍານວຍໃຫ້ອາກາດລົ້ນເຕັມທີ່ຫໍ່ຢູ່ໃນກົ່ວຂອງແຫຼວ molten, ແຕ່ຫຼັງຈາກທີ່ໃຊ້ເວລາ reflux ເພີ່ມຂຶ້ນເຖິງເວລາໃດຫນຶ່ງ, ອາກາດຫໍ່ໃນກົ່ວຂອງແຫຼວແມ່ນຍາກທີ່ຈະ overflow ອີກເທື່ອຫນຶ່ງ. ເວລາ Reflux ແມ່ນຫນຶ່ງໃນປັດໃຈທີ່ມີຜົນກະທົບຕໍ່ທໍ່ເຊື່ອມ.

ຍົກເລີກການປຽບທຽບຂອງໄລຍະເວລາ reflux ທີ່ແຕກຕ່າງກັນ
3.6 ການເຊື່ອມໂລຫະຢູ່ຕາມໂກນແລະອຸນຫະພູມ furnace ສູງສຸດ
ດ້ວຍການທົດສອບອຸນຫະພູມ furnace ສູງສຸດ 240 ℃ແລະ 250 ℃ແລະເງື່ອນໄຂອື່ນໆບໍ່ປ່ຽນແປງ, ພື້ນທີ່ຢູ່ຕາມໂກນຂອງຊັ້ນເຊື່ອມໄດ້ຖືກວັດແທກຫຼັງຈາກ reflow, ແລະເມື່ອປຽບທຽບກັບອຸນຫະພູມ furnace ສູງສຸດ 260 ℃, ມັນພົບເຫັນວ່າພາຍໃຕ້ເງື່ອນໄຂອຸນຫະພູມ furnace ສູງສຸດທີ່ແຕກຕ່າງກັນ, ຢູ່ຕາມໂກນຂອງຊັ້ນ welded ຂອງ QFN ແລະ chip ບໍ່ໄດ້ປ່ຽນແປງຢ່າງຫຼວງຫຼາຍໃນ furnace 1. ບໍ່ມີຜົນກະທົບທີ່ຊັດເຈນກ່ຽວກັບ QFN ແລະຂຸມໃນຊັ້ນເຊື່ອມຂອງຊິບ, ເຊິ່ງບໍ່ແມ່ນປັດໃຈທີ່ມີອິດທິພົນ.

ຍົກເວັ້ນການປຽບທຽບອຸນຫະພູມສູງສຸດທີ່ແຕກຕ່າງກັນ
ການທົດສອບຂ້າງເທິງຊີ້ໃຫ້ເຫັນວ່າປັດໃຈສໍາຄັນທີ່ມີຜົນກະທົບຕໍ່ຊັ້ນເຊື່ອມຂອງ QFN ແລະຊິບແມ່ນເວລາ reflux ແລະຄວາມຫນາຂອງຕາຫນ່າງເຫຼັກ.
4 solder paste ການພິມ reflow ການເຊື່ອມໂລຫະຢູ່ຕາມໂກນປັບປຸງ
4.1 ການທົດສອບ DOE ເພື່ອປັບປຸງຊ່ອງເຊື່ອມ
ຂຸມໃນຊັ້ນເຊື່ອມຂອງ QFN ແລະຊິບໄດ້ຖືກປັບປຸງໂດຍການຊອກຫາມູນຄ່າທີ່ດີທີ່ສຸດຂອງປັດໃຈທີ່ມີອິດທິພົນຕົ້ນຕໍ (ເວລາ reflux ແລະຄວາມຫນາຂອງຕາຫນ່າງເຫຼັກ). ການວາງ solder ແມ່ນ SAC305 type4, ຮູບຮ່າງຕາຫນ່າງເຫຼັກແມ່ນປະເພດຕາຂ່າຍໄຟຟ້າ (100% ລະດັບການເປີດ), ອຸນຫະພູມ furnace ສູງສຸດແມ່ນ 260 ℃, ແລະເງື່ອນໄຂການທົດສອບອື່ນໆແມ່ນຄືກັນກັບອຸປະກອນການທົດສອບ. ການທົດສອບ DOE ແລະຜົນໄດ້ຮັບໄດ້ຖືກສະແດງຢູ່ໃນຕາຕະລາງ 3. ອິດທິພົນຂອງຄວາມຫນາຂອງຕາຫນ່າງເຫຼັກກ້າແລະເວລາ reflux ໃນ QFN ແລະຮູເຊື່ອມຊິບແມ່ນສະແດງຢູ່ໃນຮູບ 12. ໂດຍຜ່ານການວິເຄາະປະຕິສໍາພັນຂອງປັດໃຈອິດທິພົນຕົ້ນຕໍ, ມັນພົບວ່າການນໍາໃຊ້ຄວາມຫນາຂອງຕາຫນ່າງເຫຼັກ 100 μmແລະເວລາ reflux 80 s ສາມາດຫຼຸດຜ່ອນການເຊື່ອມຂອງ chip QFN ຢ່າງຫຼວງຫຼາຍ. ອັດຕາການເຊື່ອມຢູ່ຕາມໂກນຂອງ QFN ແມ່ນຫຼຸດລົງຈາກສູງສຸດ 27.8% ເປັນ 16.1%, ແລະອັດຕາການເຊື່ອມຢູ່ຕາມໂກນຂອງຊິບແມ່ນຫຼຸດລົງຈາກສູງສຸດ 20.5% ເປັນ 14.5%.
ໃນການທົດສອບ, ຜະລິດຕະພັນ 1000 ໄດ້ຖືກຜະລິດພາຍໃຕ້ເງື່ອນໄຂທີ່ດີທີ່ສຸດ (ຄວາມຫນາຂອງຕາຫນ່າງເຫຼັກ 100 μm, ເວລາ reflux 80 s), ແລະອັດຕາການເຊື່ອມຂອງ 100 QFN ແລະຊິບໄດ້ຖືກວັດແທກແບບສຸ່ມ. ອັດຕາການເຊື່ອມໂລຫະຢູ່ຕາມໂກນຂອງ QFN ສະເລ່ຍແມ່ນ 16.4%, ແລະອັດຕາການເຊື່ອມໂລຫະຢູ່ຕາມໂກນຂອງ chip ສະເລ່ຍແມ່ນ 14.7% ອັດຕາການເຊື່ອມຢູ່ຕາມໂກນຂອງຊິບແລະຊິບແມ່ນຫຼຸດລົງຢ່າງຈະແຈ້ງ.

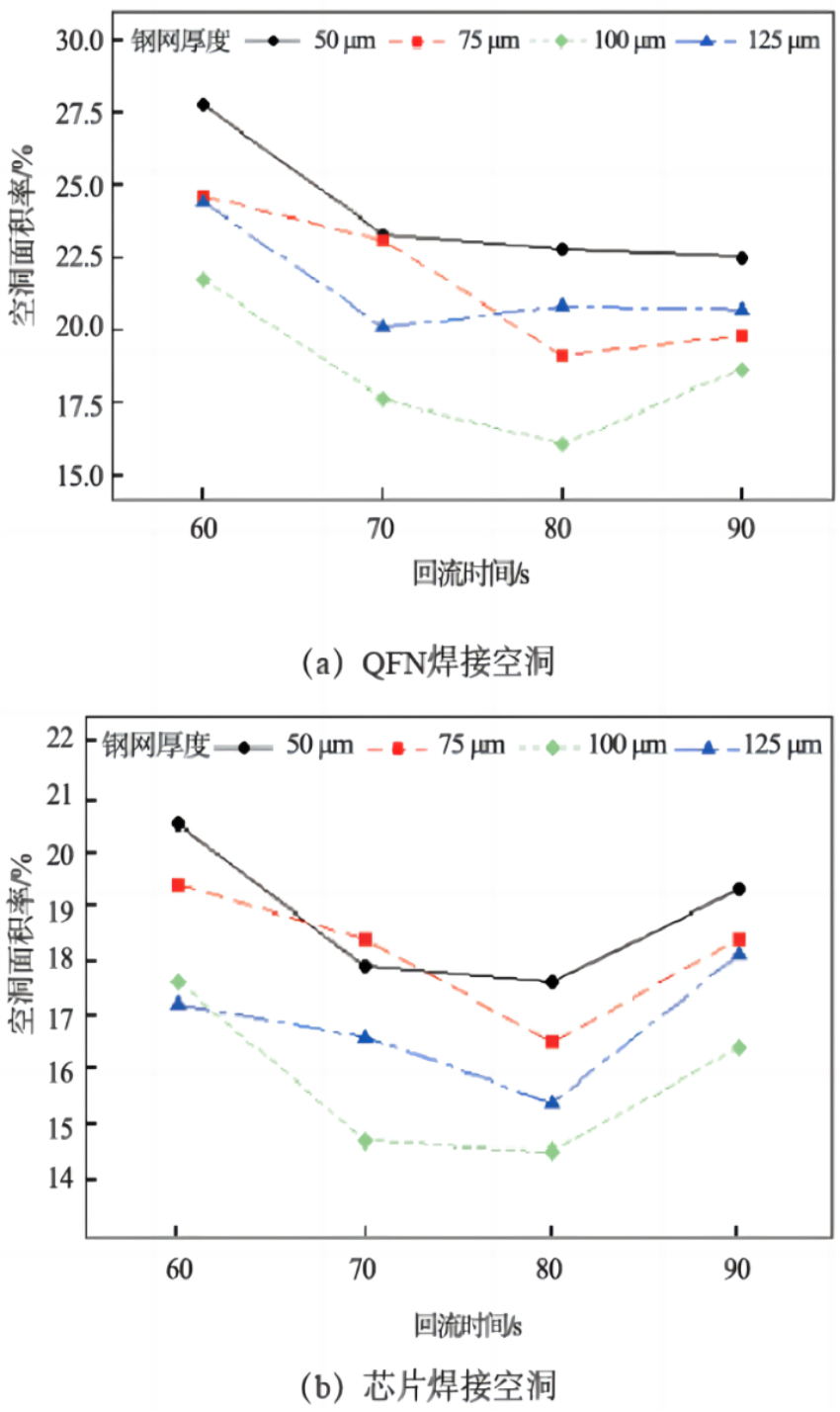
4.2 ຂະບວນການໃຫມ່ປັບປຸງການເຊື່ອມໂລຫະຢູ່ຕາມໂກນ
ສະຖານະການການຜະລິດຕົວຈິງແລະການທົດສອບສະແດງໃຫ້ເຫັນວ່າໃນເວລາທີ່ບໍລິເວນຢູ່ຕາມໂກນການເຊື່ອມໂລຫະຢູ່ທາງລຸ່ມຂອງຊິບແມ່ນຫນ້ອຍກ່ວາ 10%, ບັນຫາຮອຍແຕກຂອງ chip ຕໍາແຫນ່ງຢູ່ຕາມໂກນຈະບໍ່ເກີດຂຶ້ນໃນລະຫວ່າງການຜູກມັດແລະ molding. ຕົວກໍານົດການຂະບວນການ optimized ໂດຍ DOE ບໍ່ສາມາດຕອບສະຫນອງຄວາມຕ້ອງການຂອງການວິເຄາະແລະການແກ້ໄຂຮູຢູ່ໃນການເຊື່ອມໂລຫະ solder reflow ທໍາມະດາ, ແລະອັດຕາພື້ນທີ່ຢູ່ຕາມໂກນການເຊື່ອມຂອງຊິບຕ້ອງໄດ້ຮັບການຫຼຸດລົງຕື່ມອີກ.
ນັບຕັ້ງແຕ່ຊິບທີ່ປົກຫຸ້ມຢູ່ໃນ solder ປ້ອງກັນບໍ່ໃຫ້ອາຍແກັສໃນ solder ຈາກການຫລົບຫນີ, ອັດຕາຂຸມຢູ່ດ້ານລຸ່ມຂອງຊິບແມ່ນຫຼຸດລົງຕື່ມອີກໂດຍການກໍາຈັດຫຼືຫຼຸດຜ່ອນອາຍແກັສທີ່ເຄືອບ solder. ຂະບວນການໃຫມ່ຂອງການເຊື່ອມ reflow ທີ່ມີການພິມສອງ solder paste ໄດ້ຖືກຮັບຮອງເອົາ: ຫນຶ່ງ solder paste ການພິມ, ຫນຶ່ງ reflow ບໍ່ກວມເອົາ QFN ແລະ chip ເປົ່າ discharging ອາຍແກັສໃນ solder; ຂະບວນການສະເພາະຂອງການພິມ solder paste ທີສອງ, patch ແລະ reflux ທີສອງແມ່ນສະແດງຢູ່ໃນຮູບ 13.
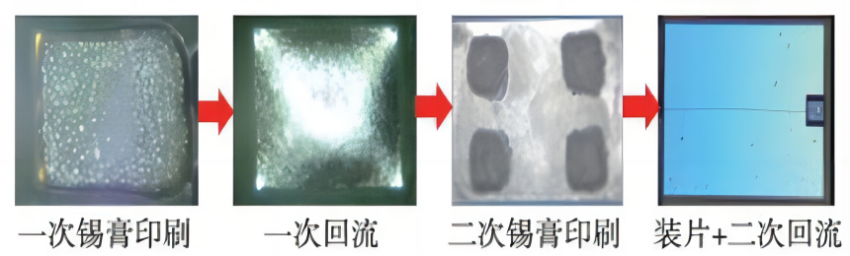
ເມື່ອແຜ່ນ solder ຫນາ 75μmຖືກພິມອອກເປັນຄັ້ງທໍາອິດ, ອາຍແກັສສ່ວນໃຫຍ່ໃນ solder ໂດຍບໍ່ມີການປົກຫຸ້ມຂອງຊິບຫນີຈາກຫນ້າດິນ, ແລະຄວາມຫນາຫຼັງຈາກ reflux ແມ່ນປະມານ50μm. ຫຼັງຈາກການສໍາເລັດຂອງ reflux ປະຖົມ, ສີ່ຫລ່ຽມຂະຫນາດນ້ອຍໄດ້ຖືກພິມລົງເທິງຫນ້າດິນຂອງ solder solidified cooled (ເພື່ອຫຼຸດຜ່ອນປະລິມານຂອງ solder paste, ຫຼຸດຜ່ອນຈໍານວນຂອງອາຍແກັສ spillover, ຫຼຸດຜ່ອນຫຼືລົບລ້າງ solder spatter), ແລະ solder paste ມີຄວາມຫນາຂອງ 50 μm (ຜົນການທົດສອບຂ້າງເທິງນີ້ສະແດງໃຫ້ເຫັນວ່າ 100 μmແມ່ນດີທີ່ສຸດ, ພິມຮອງ 10 μm, ຄວາມຫນາ 10 μm. μm = 50 μm), ຫຼັງຈາກນັ້ນຕິດຕັ້ງຊິບ, ແລະຫຼັງຈາກນັ້ນກັບຄືນຜ່ານ 80 s. ເກືອບບໍ່ມີຂຸມໃນ solder ຫຼັງຈາກການພິມຄັ້ງທໍາອິດແລະ reflow, ແລະ solder paste ໃນການພິມຄັ້ງທີສອງແມ່ນຂະຫນາດນ້ອຍ, ແລະຮູເຊື່ອມແມ່ນຂະຫນາດນ້ອຍ, ດັ່ງທີ່ສະແດງຢູ່ໃນຮູບ 14.
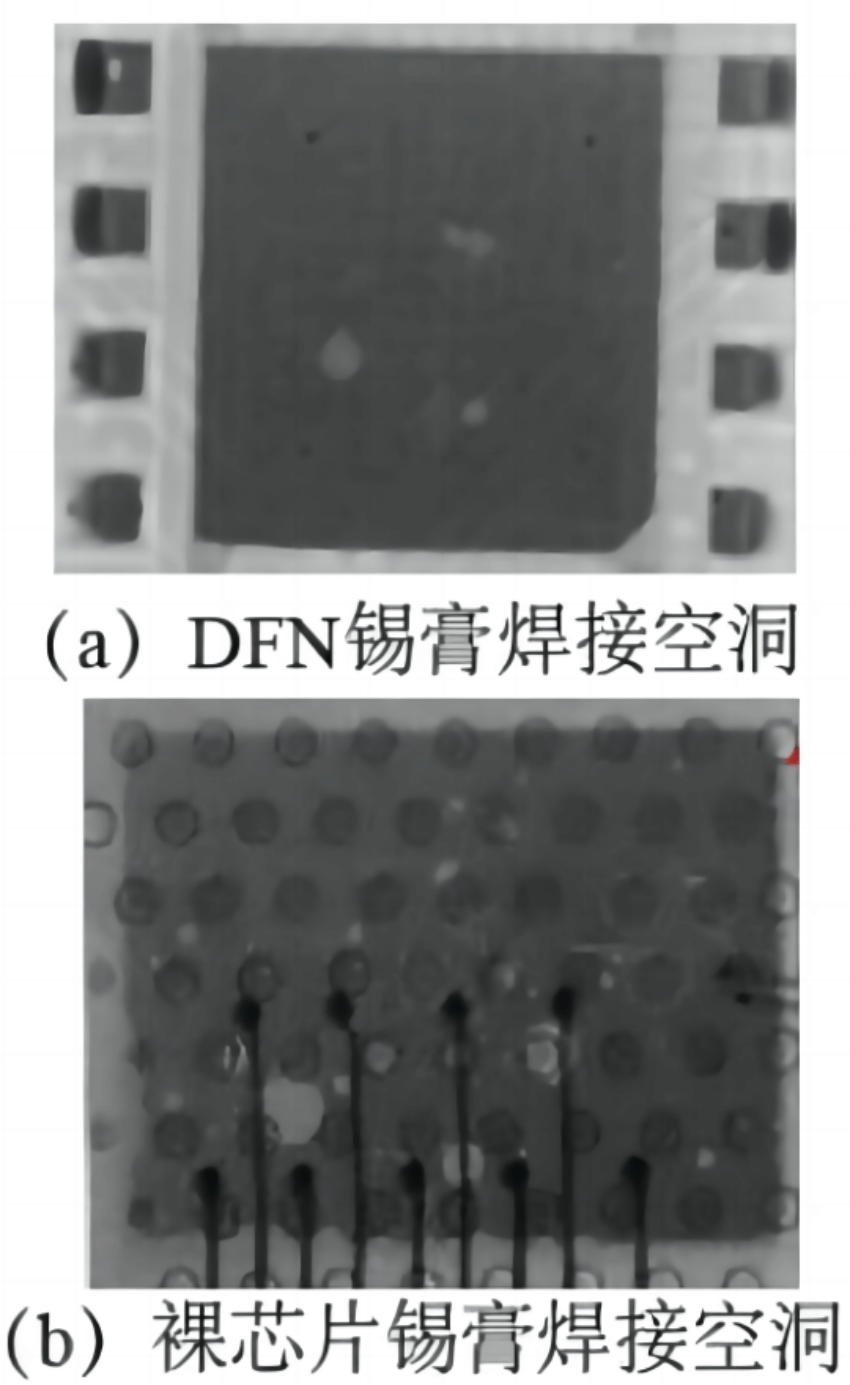
ຫຼັງຈາກການພິມສອງແຜ່ນຂອງແຜ່ນ solder, ການແຕ້ມຮູບເປັນຮູ
4.3 ການກວດສອບຜົນກະທົບຢູ່ຕາມໂກນເຊື່ອມ
ການຜະລິດ 2000 ຜະລິດຕະພັນ (ຄວາມຫນາຂອງຕາຫນ່າງເຫຼັກພິມຄັ້ງທໍາອິດແມ່ນ 75 μm, ຄວາມຫນາຂອງຕາຫນ່າງເຫຼັກພິມຄັ້ງທີສອງແມ່ນ 50 μm), ເງື່ອນໄຂອື່ນໆທີ່ບໍ່ປ່ຽນແປງ, ການວັດແທກແບບສຸ່ມຂອງ 500 QFN ແລະອັດຕາການເຊື່ອມຊິບຢູ່ຕາມໂກນ, ພົບວ່າຂະບວນການໃຫມ່ຫຼັງຈາກທໍາອິດ reflux ບໍ່ມີຢູ່ຕາມໂກນ, ຫຼັງຈາກ reflux ຄັ້ງທີສອງ QFN cavity ສູງສຸດແລະ welwel cavity. ອັດຕາຂອງຊິບແມ່ນ 4.1%. ເມື່ອປຽບທຽບກັບຂະບວນການເຊື່ອມໂລຫະການພິມແບບວາງດຽວຕົ້ນສະບັບແລະຂະບວນການທີ່ດີທີ່ສຸດຂອງ DOE, ຢູ່ຕາມໂກນການເຊື່ອມໂລຫະໄດ້ຖືກຫຼຸດລົງຢ່າງຫຼວງຫຼາຍ, ດັ່ງທີ່ສະແດງຢູ່ໃນຮູບ 15. ບໍ່ພົບຮອຍແຕກຂອງຊິບຫຼັງຈາກການທົດສອບທີ່ເປັນປະໂຫຍດຂອງຜະລິດຕະພັນທັງຫມົດ.

5 ສະຫຼຸບ
ການເພີ່ມປະສິດທິພາບຂອງຈໍານວນການພິມ solder paste ແລະເວລາ reflux ສາມາດຫຼຸດຜ່ອນພື້ນທີ່ຢູ່ຕາມໂກນການເຊື່ອມໂລຫະ, ແຕ່ອັດຕາການເຊື່ອມຢູ່ຕາມໂກນແມ່ນຍັງຂະຫນາດໃຫຍ່. ການນໍາໃຊ້ສອງ solder paste ເຕັກນິກການເຊື່ອມຕໍ່ reflow ການພິມສາມາດປະສິດທິຜົນແລະສູງສຸດອັດຕາການເຊື່ອມຢູ່ຕາມໂກນ. ພື້ນທີ່ການເຊື່ອມໂລຫະຂອງ QFN circuit bare chip ສາມາດເປັນ 4.4mm x4.1mm ແລະ 3.0mm x2.3mm ຕາມລໍາດັບໃນການຜະລິດມະຫາຊົນອັດຕາການຢູ່ຕາມໂກນຂອງການເຊື່ອມ reflow ແມ່ນຄວບຄຸມຕ່ໍາກວ່າ 5%, ເຊິ່ງປັບປຸງຄຸນນະພາບແລະຄວາມຫນ້າເຊື່ອຖືຂອງການເຊື່ອມ reflow. ການຄົ້ນຄວ້າໃນເອກະສານນີ້ສະຫນອງການອ້າງອິງທີ່ສໍາຄັນສໍາລັບການປັບປຸງບັນຫາຢູ່ຕາມໂກນການເຊື່ອມໂລຫະຂອງພື້ນຜິວການເຊື່ອມໂລຫະຂະຫນາດໃຫຍ່.






